ARM和台积电宣布使用TSMC的基板上晶片封装(CoWoS)封装解决方案共同开发基于多个ARM内核的经硅验证的小芯片系统,该封装解决方案被誉为业界首个基于7nm FinFET工艺的解决方案。
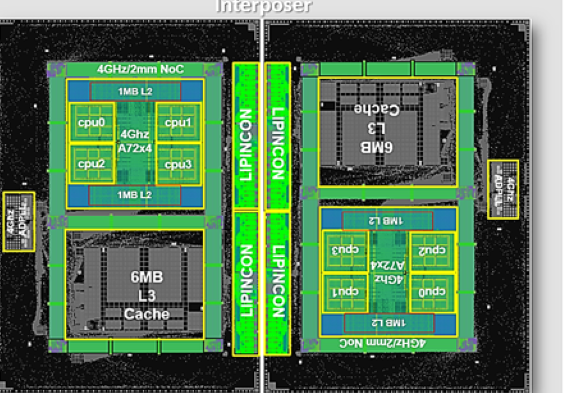
概念验证芯片包括以7nm实现的双芯片CoWoS。每个小芯片包含四个ARM Cortex-A72处理器,以及一个以4GHz运行的片上互连网格总线。该系统还具有由台积电(TSMC)开发的独特的低电压输入封装INterCONnect,可达到每引脚8Gb / s的数据速率,因此具有出色的电源效率。
台积电的低电压封装中的INterCONnect或LIPINCON,工作电压为0.3v,可达到8GT / s(每秒千兆交易)和320GB / s的带宽。列出的带宽密度为1.6TB / s /mm²,功率效率为0.56pJ / bit(微微焦耳/位)。相比之下,AMD的Infinity Fabric的功耗约为2pj / bit,而英特尔声称EMIB的功耗仅为0.3pJ / bit,MDIO的功耗为0.5pJ / bit。
这个新的小芯片概念展示了ARM和TSMC在为高性能计算(HPC)应用程序提供技术方面的潜力。ARM和台积电开发了该设计,以替代传统SoC,因为传统SoC难以制造且价格昂贵,而且产量不高。
小芯片不再依赖于传统的SoC方法,该方法将每个系统组件组合到一个裸片上,而是将大型多核设计划分为较小的芯片组。这为将功能拆分为较小的芯片提供了一种更有效的方法,从而允许使用不同的处理技术来生产每个小芯片。
这项新设计的主要意义在于,事实证明,现在台积电的概念验证LIPINCON互连技术已经可以使用。因此,客户将能够利用它,并且将来它可能会进入商用HPC产品。
KitGuru说:ARM和TSMC现在都已证明它们有能力进行高效的HCP芯片设计。这对于HPC系统和两者之间的未来合作意味着什么?
